-
반도체 관련 용어 정리기초지식 2020. 6. 19. 10:08
IN -> BCT -> H/B -> COL -> COT -> SOB -> COL -> TARC -> H/B -> COL -> WEE -> EXP ->
PEB -> COL -> DEV -> ADI -> OUT
PR(Photo Resist, 감광성 고분자(감광제)) : 특정 파장의 빛에 의해 성질(용해도)이 변하는 물질로 Positive PR, Negative PR 2가지 종류가 있다.
Positive PR : 빛을 받은 부위가 현상액에 의해 제거되는 물질
Negative PR : 빛을 받은 부분이 현상액에 의해 제거되지 않는 물질
BCT(Bottom Coating) : BARC 공정. 포토제지스트 코팅 전의 반사방지막 공정
BARC(Bottom Anti-reflective coating) : 노광된 빛의 하부 반사 및 산란의 제어를 통해 공정상의 문제점인 Standing wave, Notching 등을 억제하여 미세회로를 구현할 수 있도록 하는 재료
COT(Coating) : 포토레지스트 토포
TARC(Top Anti-Reflective Coating) : 포토레지스트 공정 후에 포토레지스트 위에 실시하는 반사방지막 공정

이미지 출처 : http://www.dongjin.com/business/semiconductor.php WEE(Wafer Edge Expose) : Spin Coating으로 PR을 도포했을 경우 Wafer의 가장자리의 PR 두께가 원심력에 의해서 가장 두껍다. 가장자리를 제거하는 과정을 Edge-Bead Removal이라고 하며, EBR은 PR 공정이후에 Solvent로 가장자리를 제거하는 작업을 주로 지칭하고, WEE 는 광학적으로 Edge를 태우는 작업을 지칭한다.

이미지 출처 : https://primelite.de/uv-led-semiconductor-manufacturing/uv-led-wafer-edge-exposure H/B(Hard Baker) : 잔여 Solvent를 제거하고 PR을 건조시켜 기판에 대한 PR의 집착도를 증가시키는 공정(100도 이상)
SOB(Soft Baking) : PR에 존재하는 Solvent를 제거
EXP(Exposure, 노광공정) : PR을 도포한 Wafer표면에 회로가 구성되어 있는 Mask를 정렬시켜 자외선을 쬐는 작업
PEB(Post Exposure Bake) : 노광(Exposure)시에 PR의 PAC가 농도 차이가 생겨서 Profile 이 물결치는 현상(standing wave)이 발생. 현상하기 전에 PEB를 통해서 열을 가하면 빛반응화합물(PAC)를 확산시켜 PR 성분을 재정렬 시키기 위해서 실시 ( Soft Baking 보다 높은 온도에서 수행 )
DEV(Development, 현상공정) : 감광액 도포 및 노광 후 필요한 부분만 남기고 불필요한 부분의 감광액을 제거하는 공정
ADI(After Development Inspection) : 현상이 끝난 후에 형성된 PR , 패턴의 정확성을 검사
참고사이트 :
https://m.blog.naver.com/jgw1030/221170867513
SeMi뀨의 공정강의-노광공정(Photo lithography process), PR, 노공, 회절, 분해능, 해상도(Resolution), DOF, EUV,
노광공정(포토리소그래피공정)의 전체적인 그림은 다음과 같습니다. 이제부터 노광공정의 모든 것을 배워 ...
blog.naver.com
반도체공학[5] - Photo Lithography(HMDS, PR, EBR, SOB, Alignment, Exposure, PEB, Develop, PDB, ADI)
Semiconductor Engineering. 5*Photo LithographyPhoto Lithography 공정 기술은 Mask에 설계된 소...
blog.naver.com
기타 용어
* RRC(Resist Reduced Coating)
* EBR(Edge Bead Removal) : Photo Sping Coating 공정 후 실리콘 웨이퍼 가장자리의 불필요한 Photoresist를 제거하는 공정. Spin Coat 공정 이후에 Solvent 용액을 가장자리에 뿌리는 방식으로 수행.
고속회전하는 웨이퍼의 가장자리에 강광막을 용해시키는 액상용매를 분사하여 웨이퍼의 가장자리의 감광막을 제거하는 방법
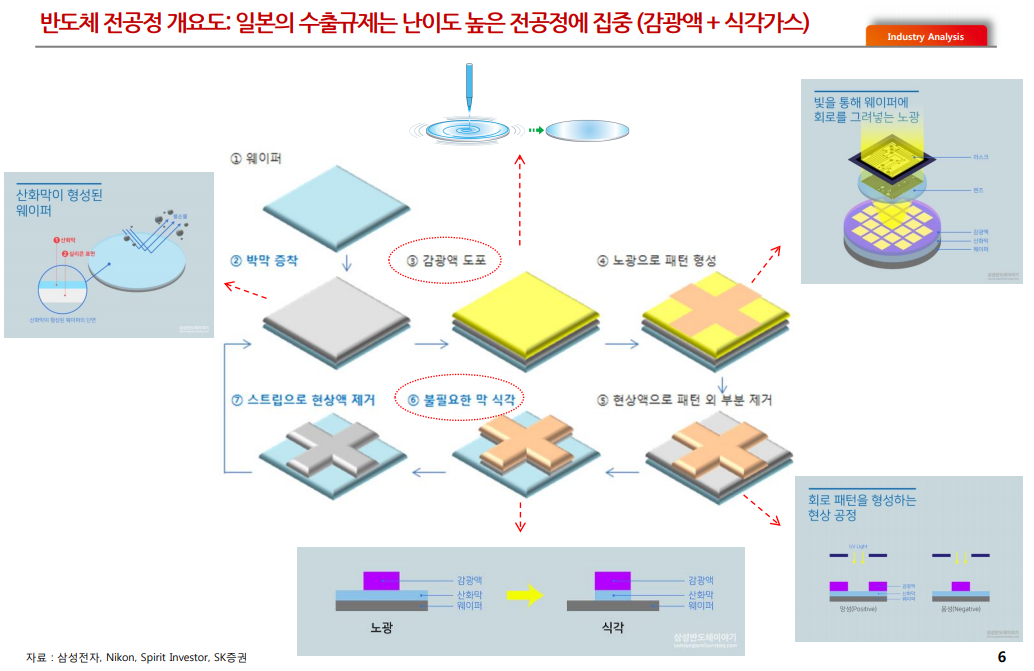
이미지 출처 : SK_190805__한일대응전략_I_Semiconductors&_SK_560835.pdf '기초지식' 카테고리의 다른 글
Arduino에서 WS2813B(WS2812B) LED Strip을 이용한 조명제작 (0) 2020.07.03 반도체 검사관련 용어정리 (0) 2020.06.30